Дипломная работа: Эпитаксиальный рост Ge на поверхности Si(100)
1) Химическая очистка:
С термически
окисленных (на толщину около 1 мкм) пластин кремния, удаляется оксидный слой SiO2 плавиковой кислотой (HF). Затем пластина равномерно окисляется раствором H2O2+NH4OH+H2O.
После такой химической обработки, на поверхности остается тонкий (несколько
монослоев) и чистый от примесей слой оксида кремния SiO2. После чего производится тщательная промывка в
деионизованой воде и сушка в парах ацетона.
2) Удаление оксида
кремния:
Температура подложки
устанавливается порядка 800°C.
Подпыление поверхности пластины небольшим потоком кремния, восстанавливает
двуокись кремния до моноокиси, которая при данной температуре десорбирует с
поверхности. Поток кремния в процессе очистки составляет ~5x1013 ат/см2сек.
При этом ведется наблюдение дифракционной картины поверхности подложки. При
нормальном ходе процесса очистки, по истечении около двух минут начинает
исчезать диффузный фон, и увеличивается яркость основных рефлексов. Завершение
процесса очистки отличается появлением сверхструктурных рефлексов 7x7 для
Si(111) и 2x1 дляSi(100).
3) Рост буферного
слоя:
Для сглаживания
макронеровностей оставшихся после шлифовки и предыдущих этапов обработки
поверхности выращивается буферный слой кремния толщиной порядка 100нм.
Температура поверхности устанавливается 700°C, рост осуществляется в течении пяти - десяти минут со
скоростью осаждения 1015 ат/см2сек.
Данная система
подготовки поверхности производится один раз.
Перед каждым новым
осаждением германия пластина отжигалась при температуре 1100°C в течении двадцати минут. Для
уменьшения влияния "истории" образца, из-за частичного растворения
германия в подложке при отжиге, поверхность заращивалась слоем кремния ~200-300Å.
Затем для выглаживания поверхности образец снова отжигался в течении 10 минут,
после чего охлаждался естественной теплоотдачей (без принудительного
охлаждения) до температуры последующего роста.
Проводя однообразно
прогрев, охлаждение и заращивание кремнием перед каждым экспериментом, мы
ожидаем минимального изменения исходной поверхности от эксперимента к
эксперименту. О чем свидетельствует характерная дифракционная картина (2x1) для Si(100) реконструированной поверхности, наблюдаемая после всех
предэпитаксиальных подготовок.
Результаты эксперимента
Исследован методом ДБЭ
рост слоев германия на кремнии в диапазоне температур от 250 до 700ОС.
На рис.7 представлена характерная дифракционная картина поверхности Si(100), при дифракции быстрых
электронов на отражение под малым углом падения.

Рисунок 7. Дифракционная картина чистой поверхности Si(100).
Центральное пятно –
рефлекс зеркально отраженного пучка электронов. Три темные полосы, крайние
боковые и центральная – тяжи, полученные пересечением обратной двумерной
решетки со сферой Эвальда. Между ними находятся сверхструктурные тяжи,
возникающие из-за присутствия на поверхности дополнительной периодичности (2x1).
На рис.8 показана
характерная дифракционная картина от поверхности псевдоморфной пленки Ge на Si(100). Толщина слоя Ge равна 2 монослоя.

Рисунок 8. Дифракционная картина поверхности Si(100) с пленкой Ge 2 монослоя.
Стрелками показаны тяжи от реконструкции (8x2).
При толщине пленки
около 1 монослоя (МС) на дифракционной картине формируется сверхструктура (2xN) где N=8-12. Эта структурная
перестройка заключается в удалении рядов димеров с поверхности плёнки, что
приводит к частичной упругой релаксации напряженного гладкого германиевого
слоя, в результате на дифракционной картине появляются дополнительные сверхструктурные
тяжи.
При дальнейшем
увеличение толщины Ge, из-за роста с
толщиной энергии напряжений, с некоторой толщины, пленке становится выгоднее
частично снять напряжения за счет увеличения площади поверхности. В результате
на поверхности подстилающего слоя начинают образовываться островки("hut" кластеры), когерентно
сопряженные в основании с подложкой и имеющие форму четырехгранных пирамид с
ориентацией граней типа {105}. В результате, на дифракционной картине тяжи от
дифракции на поверхности заменяются на рефлексы от объемной дифракции (на
просвет) от островков. Из-за четкой огранки островков, возле объемных
рефлексов, появляются линии обусловленные рассеянием на гранях островков (см.
рис.8).
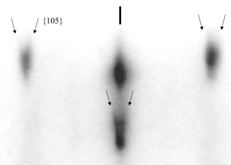
Рисунок 9.Дифракционная картина поверхности Si(100) с Ge "hut" кластерами (толщина пленки - 6 монослев). Стрелками
показаны линии от рассеяния на гранях островков.
Увеличение толщины
пленки Ge приводит к постепенному увеличению размеров "hut" островков,
и при некоторой толщине трансформации "hut" островков в "dome".
Характерная дифракционная картина от поверхности с "dome" островками
показана на рис.9.

Рисунок 10. Дифракционная картина поверхности Si(100) с Ge "dome" островками (толщина пленки - 15 монослев).
Стрелками показаны линии от рассеяния на гранях островков.
Расстояние на
дифракционной картине между тяжами, в случае дифракции от поверхности или
рефлексами, в случае дифракции от объема напрямую отражает значение параметра
решетки (~1/a). Следя за изменением расстояния
сначала между тяжами, а затем между положением объемных рефлексов можно
контролировать "параметр решетки" растущей пленки в плоскости роста.
На рис.10 представлено характерное поведение положения тяжей, в точках
последующего появления объемных рефлексов.
Стрелками на рисунке
показаны места на дифракционной картине вдоль которых снимался профиль
интенсивности в процессе роста. Как видно из рисунка, в процессе роста
расстояние между тяжами меняется. В начальный момент, когда дифракционная
картина образована рассеянием на чистой поверхности кремния, можно считать, что
расстояние между тяжами (l0) в этом случае соответствует
параметру решетки объемного кремния. Тогда, изменение эффективной постоянной
решетки в процессе роста можно вычислить по формуле:
da/a=1-l/l0
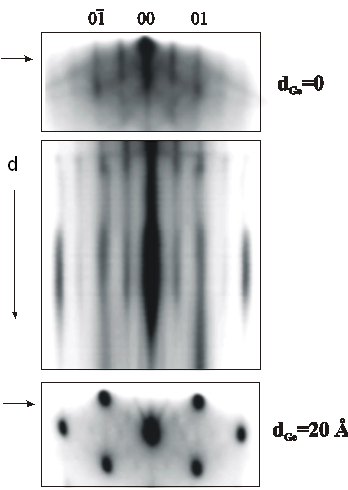
Рисунок 11. Изменение профиля интенсивности дифракционной
картины вдоль горизонтального направления в процессе осаждения Ge на Si(100). Вверху и внизу
показаны начальное и конечное изображение дифракционной картины.
Электронный луч,
падающий под малым углом на поверхность (~0.50), проникает в
поверхность неглубоко ~1-3 монослоя (для данной энергии электронов – 20кВ),
поэтому параметр решетки рассчитанный из дифракционной картины соответствует
параметру решетки самых верхних слоев поверхности.
На рис.12 показано
характерное изменение эффективного параметра решетки в плоскости роста.
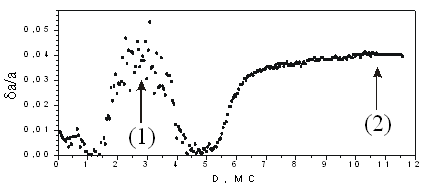
Рисунок 12. Изменение "параметра решетки" в
процессе осаждения. (1) – Переход 2D-3D.
(2) – Полная релаксация "dome" островков.
На зависимости
параметра решетки от толщины можно выделить несколько характерных моментов
изменения поведения:
Начиная с толщины
пленки около одного монослоя и до трех монослоев, наблюдается рост параметра
решетки.
В этой области
напряженной пленке германия становится выгоднее иметь на поверхности большое
количество двумерных островков, т.к. они частично снижают напряжения за счет
релаксации. При этом, оказываясь сжатыми в основании, на верхней, свободной
границе островки могу быть наоборот растянуты. С увеличением толщины пленки,
увеличивается энергия упругих напряжений в пленке, и для ее снижения
поверхности выгоднее иметь все большее и больше количество двумерных островков.
2. С трех до пяти
монослоев происходит падение параметра решетки до значения почти
соответствующему значению параметра решетки кремния.
При толщине пленки
около 3 монослоя на месте двумерных островков начинают образовываться
трехмерные островки, когерентно сопряженные в основании с подложкой.
Дифракционная картина в данной ситуации представляет собой сумму от дифракции
на поверхности смачивающего слоя и только зародившихся трехмерных островков.
Профиль интенсивности снимается в точке появления объемных рефлексов,
интенсивность которых на данной стадии еще мала, поэтому основной вклад в
интенсивность в выбранной на картине точке будет давать псевдоморфный
смачивающий слой германия, который имеет в плоскости роста параметр решетки как
у кремния. Поэтому переход 2D - 3D к временному падению эффективного
параметра решетки растущей пленки.
3. С толщины пленки
порядка пяти монослоев идет постепенное увеличение параметра, до тех пор, пока
не достигнет значения параметра решетки объемного германия.
По мере падачи
материала на поверхность, трехмерные островки увеличиваются в размерах. "Hut" островки, будучи когерентно
сопряжены в своем основании с подстилающим слоем, имеющим в плоскости роста
параметр решетки кремния, к своей вершине постепенно релаксируют. И чем больше
размер островка, тем большие толщины подвержены релаксации. "Dome" островки срелаксированны еще
больше. При некоторой толщине пленки введенные в "dome" островки дислокации несоответсвия уже настолько
снимают напряжения в островках, что электронный луч прошедший через островок "чувствует"
в нем параметр решетки объемного германия.
Были так же измерены
изменения вертикального профиля интенсивности вдоль нулевого тяжа от времени
роста пленок (рис.13а). Рисунок представляет из себя последовательность
профилей интенсивности вдоль нулевого тяжа в зависимости от толщины пленки
германия. Угол отложен в соответствии с дифракционными картинами, приведенными
на рис.7-10 (т.е. дифракционный угол увеличивается вниз). На протяжении роста
первых 2-3 МС на профилях присутствует один максимум, который соответствует
зеркальному рефлексу. Эта область соответствует двумерно-слоевому росту пленки.
Затем интенсивность зеркального рефлекса уменьшается, а рядом разгорается
объемный рефлекс. По мере роста пленки, интенсивность объемного рефлекса
увеличивается, и при некотором значении толщины пленки происходит сдвиг
объемного рефлекса в сторону больших углов.
Таким образом можно
выделить три характерных области по толщине пленки, которые хорошо согласуются
с изменениями дифракционных картин:
1. До начала перехода
к трехмерному росту (<3MC)
профиль представляет из себя в основном узкий и интенсивный пик, зеркального рефлекса.
В этой области
происходит сверхструктурный переход 2х1 в 2хN, который явно не проявляется на профилях интенсивности, но
сопровождается существенным снижением интенсивности зеркального рефлекса при
толщине пленки около 1МС.
2. После перехода к
трехмерному росту (>5-10MC и
>3-4MC) профиль также представлят из себя
более узкий и интенсивный пик, теперь являющийся объемным рефлексом. По мере
роста пленки происходит изменение в интенсивности и сильное смещение объемного
рефлекса.
Как уже указывалось
выше, в этой области толщин наблюдаются дифракционные картины, свидетельствующие
об образовании псевдомофных "hut" кластеров с ориентацией граней типа {105}.
3. При больших
толщинах (>5-10MC), как уже
указывалось выше, рефлекс постепенно смещается в сторону больших углов.
В этой области толщин
наблюдаются дифракционные картины, свидетельствующие об образовании трехмерных
островков с дислокациями несоответствия и огранкой типа {113}.
На рис.13 цифрами
указаны моменты смены характерных областей на профиле.
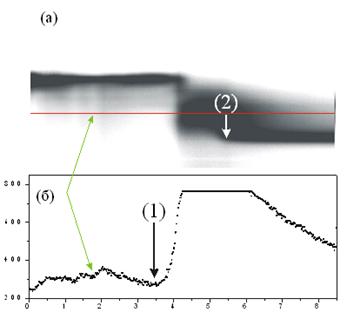
Рисунок 13. (а) – Изменение профиля интенсивности
дифракционной картины вдоль вертикального направления в процессе осаждения Ge на Si(100). (б) – Изменение
интенсивности вдоль выделенное линии на (а). (1) – Переход 2D
– 3D рост (начало образования "hut"
островков). (2) – Переход "hut"
– "dome".
Таким образом из
анализа изменения горизонтального и вертикального профиля интенсивности
дифракционной картины можно выделить три характерные толщины растущей пленки:
(1) – переход от двумерного роста к трехмерному и начало образования на
поверхности "hut"
островков, (2) – переход "hut"островков
в "dome" и (3) – полная релаксация "dome" островков. На рис.14 представлена кинетическая диаграмма морфологии поверхности
пленки Ge на Si(100) в процессе роста, в зависимости от эффективной толщины
осажденного германия и температуры роста.
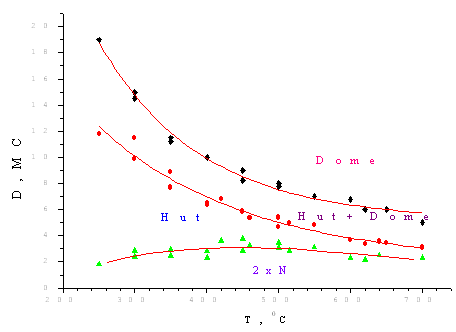
Рисунок 14. Кинетическая диаграмма морфологии поверхности
пленки Ge на Si(100). Скорость
осаждения Ge – 0.05МС/сек.
Точность положения
точек по относительной температуре в пределах 1-2%, по абсолютной температуре
(сдвиг по температуре всей диаграмм) около 200. Точность по
определению характерных толщин, составляет около 10% и определяется в основном
неточностью определения скорости потока германия на поверхность и стабильностью
работы источника.
Обсуждение результатов
Сравнение диаграммы с данными имеющимися в литературе
Несмотря на большое
количество работ, публикуемых в журналах по теме роста Ge на поверхности Si(100), данных которые можно было бы напрямую соотнести с результатами
данной работы не много. Связано это с рядом обстоятельств. Во первых, почти
половина работ по данной тематике посвящена исследованию роста твердого
раствора GexSi1-x на Si(100).
Эффективная постоянная решетки твердого раствора отличается от объемной решетки
кремния уже не на 4%, как для случая эпитаксии чистого германия, а меньше, в
зависимости от x. В результате,
такие параметры растущей пленки, как критическая толщина перехода 2D - 3D, характерные размеры "hut" и "dome" островков могут значительно увеличиться.
Получать изображение поверхности пленок с большими островками гораздо легче, и
это можно делать "на воздухе" в атомарно-силовом микроскопе. Для
получения изображений маленьких островков, обычно применяют сканирующую
электронную микроскопию, без контакта образца с воздухом, либо просвечивающую
электронную микроскопию уже захороненных островков.
Во вторых, много работ
посвящено поиску оптимальных условий параметров роста, таких как, начальная
структура поверхности, скорость и температура осаждения, временные задержки в
процессе роста, использование сурфактантов и углеродных добавок и др.
На рис.15 представлено
расположение экспериментальных точек, взятых из печатных источников
[2,20,26,35,39,, ,,,,], по отношению к зависимостям, полученным в данной
работе.
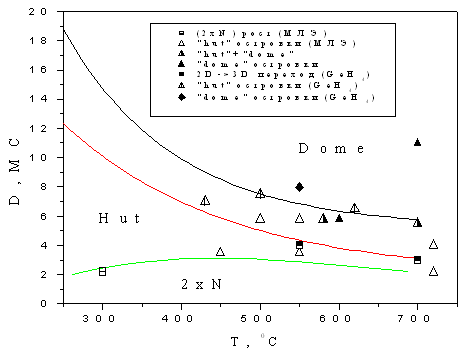
Рисунок 15. Сравнение литературных данных (тщчки)с
результатами эксперимента в данной работе(сплошные линии).
Экспериментальные
точки, с использованием метода газофазной эпитаксии лежат на несколько
монослоев выше, чем для молекулярно-лучевой эпитаксии. Связано это с тем, что
при осаждении из газовой фазы на поверхности растущей пленки присутствует
водород, который уменьшает поверхностную диффузию адатомов и меняет энергию
границы раздела кристалл-вакуум, т.е. действует аналогично сурфактанту. В
остальном наблюдается удовлетворительное соответсвие экспериментальных наблюдений.
1). Температурное
поведение 2D-3D перехода.
Поведение границы
послойного и трехмерного роста при изменении температуры роста определяется
характерной длинной миграции адатомов по поверхности.
На диаграмме
морфологии поверхности видно низкотемпературное (T<2500C) и
высокотемпературное (T>5500C) уменьшение эффективной толщины Ge
пленки, при которой происходит смена 2D - 3D механизма роста. Для эпитаксии при
низких температурах, из-за диффузионного уменьшения длинны миграции адатомов Ge
по поверхности, происходит постепенная трансформация от двумерно островкового
механизма роста к многоуровневому, когда новые двумерные островки образуются на
нижележащих двумерных островках, еще не успевших срастись в сплошной монослой.
По теоретическим расчетам, растущей поверхности напряженной германиевой пленки,
на стадии двумерного послойного роста, выгодно быть шероховатой (т.е. иметь на
поверхности двумерные островки) для снижения энергии упругих напряжений. При
высоких температурах поверхностная диффузия адатомов достаточна, чтобы собрать
атомы вокруг двумерного островка из подстилающего слоя или просто для
перестройки двумерного островка, для образования более выгодной конфигурации
пленки (с "hut"
островками), поэтому переход к трехмерному росту происходит раньше. А при
меньших температурах, кинетические ограничения приводят к тому, что зарождение
3D островков начинается немного позже.
2). Температурное
поведение перехода "hut"
- "dome" и полной релаксации "dome" островков.
Как видно из
зависимости во всем температурном диапазоне происходит плавное уменьшение
характерных толщины перехода из "hut" в "dome"
и толщины, при которой происходит полная релаксация "dome" островков. По многочисленным
теоретическим расчетам "hut"
островки являются метастабильными, и отжиг, даже при температурах роста,
приводит к постепенному переходу "hut" островков в "dome" островки. Поэтому наряду с термодинамическими параметрами
системы (конкуренция между упругими напряжениями и площадью поверхности),
важную роль играют кинетические процессы переноса на поверхности. При низких
температурах роста, кинетический массоперенос по поверхности гораздо меньше,
поэтому трансформация "hut"
кластеров в более стабильные "dome" островки происходит при больших толщинах. В то время как при более
высоких температурах роста образующиеся "dome" островки для выстраивания своей формы в
конфигурацию с минимумом энергии могут получать атомы Ge не только из падающего
потока, но и собирать из близлежащих "hut" кластеров и смачивающего слоя. К тому же, при
боле высоких температурах, введение дислокаций несоответствия в островок
возможно при меньших напряжениях в островке, а значит при меньших эффективных
толщинах германиевой пленки.
Выводы
По результатам
проведённых исследований можно сделать следующие выводы:
1). Предложена методика контроля
морфологии пленки Ge при эпитаксии
на поверхности Si(100) с помощью регистрации и анализа изменения профилей
интенсивности на дифракционной картине быстрых электронов.
2). Измерены изменения профилей
интенсивности вдоль вертикального и горизонтального направления дифракционной
картины при эпитаксии Ge на Si(100) в температурном диапазоне 250-7000С,
при постоянной скорости роста – 0.05Å/сек.
3). Из анализа изменения
горизонтального профиля интенсивности определено поведение параметра решетки
пленки в плоскости роста в зависимости от эффективной толщины напыляемого слоя
германия.
4). Предложена модель, объясняющая
подобное поведение параметра решетки пленки в плоскости роста. Увеличение
параметра решетки на стадии двумерного роста и формирования "hut"-кластеров обусловлено упругой
деформацией, а для "dome"-кластеров
– пластической релаксацией из-за формирования сетки дислокаций несоответствия в
границе раздела.
5). По характерным изменениям в
профилях интенсивности, построена кинетическая диаграмма морфологии поверхности
пленки Ge на Si(100) в зависимости от температуры роста и толщины осажденного
германия.
эпитаксия
дифракционный электрон кластер
Благодарности
Выражаю огромнейшую
благодарность моему научному руководителю к.ф.-м.н. Никифорову А.И. за частые
обсуждения вопросов непосредственно связанных с моей дипломной работой, за
поощрение и помощь при проявлении мной инициативных начинаний, а так же за
дружественный дух, который царит в его рабочей группе.
Хочу поблагодарить так
же к.ф.-м.н. Соколова Л.В. за обсуждение некоторых вопросов по интерпретации
экспериментальных зависимостей.
Благодарю к.ф.-м.н.
Чикичева С.И. за интересные, занимательные спецсеминары проводимые им со
студентами кафедры.
Cписок литературы
D.J. Paul. «Silicon germanium heterostructures in electronics: the
present and the future»Thin Solid Films, 321 (1998), 172-180.
D.J. Eaglesham and M. Cerullo. «Dislocation-Free Stranski-Krastanow
Growth of Ge on Si(100)» Phys. Rev. Lett., 64, 1943 (1990).
P. Muller and R. Kern. «Equilibrium shape of epitaxially strained
crystals (Volmer-Weber case)» J. Cryst. Growth, 193, 257 (1998).
А.А. Чернов, Е.И. Гиваргизов, Х.С. Багдасаров и др. Современная
кристаллография, т. 3. М.: Наука, 1980, 407 стр.
F. Liu and M.G. Lagally. «Interplay of Stress, Structure, and
Stoichiometry in Ge-Covered Si(001)» Phys. Rev. Lett., 76, 3156 (1996).
Y. Chen and J. Washburn. «Structural Transition in Large-Lattice-Mismatch
Heteroepitaxy» Phys. Rev. Lett.,77, 4046 (1996).
D.E. Jesson, G. Chen, K.M. Chen, and S.J. Pennycook. «Self-Limiting
Growth of Strained Faceted Islands» Phys. Rev. Lett., 80, 5156 (1998).
M. Kästner
and B. Voigtländer, «Kinetically
Self-Limiting Growth of Ge Islands on Si(001)» Phys. Rev. Lett., 82, 2745
(1999).
Н.В. Востоков, С.А. Гусев, И.В.Долгов, Ю.Н. Дроздов и др. , «Упругие
напряжения и состав самоорганизующихся наноостровков GeSi на Si(001)» ФТП, №2
(2000)
V.A. Shchukin, D. Bimberg. «Strain-driven self-organization of
nanostructures on semiconductor surfaces» Appl. Phys., A 67, 687 (1998).
P. Muller, R. Kern. « Equilibrium shape of epitaxially strained crystals
(VolmerÐWeber case)» J. Cryst. Growth, 193, 257 (1998).
Ф.
Бехштенд, Р. Эндерлайн «Поверхности и границы раздела полупроводников», М.,
«Мир», 1990.
O.L. Alerhand, A.N. Berker, R.J. Hamers, et al «Finite-Temperature Fase
Diagram of Vicinal Si(100) Surface» Phys. Rev. Let. V64, N20 (1990) 2406.
Y.-W. Mo, D.E. Savage, B.S. Swartzentruber, and M.G. Lagally. Phys. Rev.
Lett., 65, 1020 (1990).
Feng Liu, M.G. Lagally «Self-organized nanoscale structures in Si/Ge
films» Surface Science 386 (1997) 169–181
G. Capellini,a) L. Di Gaspare, and F. Evangelisti « Atomic force
microscopy study of self-organized Ge islands grown on Si(100) by low pressure
chemical vapor deposition» Appl. Phys. Lett. 70 (4), 27 January 1997
F.K. LeGoues, M.C. Reuter, J. Tersoff, M. Hammar, and R.M. Tromp. Phys.
Rev. Lett., 73, 300 (1994).
V.A.Markov, A.I.Nikiforov, O.P.Pchelyakov "In situ" Control of
Direct MBE Growth of Ge Quantum Dots on Si. J.Cryst.Growth 175/176(1997)
736-740.
J. Drucker and S. Chaparro «Diffusional narrowing of Ge on Si(100)
cjherent island quantum dot size distribution» Appl. Phys. Lett. 71(5), 614
(1997).
Z. Jiang, H. Zhu, F. Lu et al. «Self-organized germanium quantum dots
grown by molecular beam epitaxy on Si(100)». Thin Solid Films, 321, 60 (1998).
K. Sakamoto, H. Matsukata «Alagnment of Ge three dimensional islands on
faceted Si(100) surface» Thin Solid Films 321 (1998) 55-99.
V.A. Markov, O.P. Pchelyakov, L.V. Sokolov et al.. «Molecular beam
epitaxy with synchronization of nucleation» Surface Sci., 250, 229 (1991).
O.P. Pchelyakov, I.G. Neisvestnyi, Z.Sh. Yanovitskaya. Phys. «RHEED
control of nanjstructures formation during MBE» Low-Dim. Struct., 10/11, 389
(1995).
J.A. Floro, E. Chason, M.B. Sinclair, L.B. Freund, G.A. Lucadamo. «Dynamic
self-organization of strained islands during SiGe epitaxial growth» Appl. Phys.
Lett., 73, 951 (1998).
V. Thanh, v. Yam, F. Fortuna at e. «Vertically self-organized Ge/Si(001)
quantum dots in multiplayer structure» Phys. Rev. B V60 N8, 5851 (1999-II)
Y.W. Zhang, S.J. Xu, and C.-h. «Vertical self-alignment of quantum dots
in superlattice» Chiu. Appl. Phys. Lett., V74, N13, 1809 (1999).
K. Sakamoto, H. Matsuhata, M.O.
Tanner, D. Wang , K.L. Wang. «Alignment of Ge three-dimensional islands on
faceted Si(001) surfaces»Thin Solid Films, 321 (1998), 55-59.
H. Omi , T. Ogino. Applied Surface Science «Self-organization of
nanoscale Ge islands in Si/Ge/Si(113) multiplayers» 130–132, (1998) 781-785
C.S. Peng, Y.H. Zhang, T.T.Sheng et al. «Improvement Ge self-organizd
quantum dots by use of Sb surfactant» Appl. Phys. Lett., V72, N20, 2541 (1998).
T. Tezuka and N. Sugiyama. «Two
types of growth mode for Ge clasters on Si(100) substrate with and without
atomic hydrogen exposure prior to the growth» J. Appl. Phys., V83, N10 5239
(1998).
V. Le Thanh. «Fabrication of SiGe quantum dots: a new approach based on
selective growth on chemically prepared H-passivated Si(100) surfaces»Thin
Solid Films 321(1998), 98-105.
X. Deng and M. Krishnamurthy.
Phys. «Self-Assembly of Quantum-Dot Molecules: Heterogeneous Nucleation of SiGe
Islands on Si(100)» Rev. Lett., 81, 1473 (1998).
O.G. Schmidt, C. Lange, K. Eberl,
O. Kienzle, F. Ernst. «Influence of pre-grown carbon on the formation of
germanium dots» Thin Solid Films, 321, 70 (1998).
G. Abstreiter, P. Schittenhelm, C. Engel, et al. «Growth and
characterization of self-assembled Ge-rich islands on Si» Semicond. Sci.
Technol. 11, 1521 (1996).
A.I. Yakimov, A.V. Dvurechenskii, A.I. Nikiforov «Normal-incidence
infrared photoconductivity in Si p-i-n diode with embedded Ge self-assembled
quantum dots»Appl. Phys. Lett.,75, 1413 (1999).
V.A.Markov, A.I.Nikiforov and O.P.Pchelyakov «In situ RHEED control of
direct MBE growth of Ge quantum dots on Si(001)» // J.Crystal Growth
175/176(1997) 736-740.
O.P. Pchelyakov, V.A. Markov, A.I. Nikiforov, L.V. Sokolov. «Surface
processes and phase diagram in MBE growth of Si/Ge geterostructures» Thin Solid
Films. 306, 299 (1997).
I. Goldfarb, G.A.D. Briggs «Comparative STM and RHEED studies of
Ge/Si(001) and Si/Ge/Si(001) surfaces» // Surface Science 433–435 ( 1999)
449–454
J.H.Neave, P.J.Dobson, B.A.Joyce and Jing Zhang «Reflection High-Energy
Electron Diffraction oscillation from vicinal surfaces-a new approach to
surfaces diffusion measurement» // Appl.Phys.Lett. 47(2) 15July 1985 p.100-102.
K.Reginski, M.A. Lamin, V.I. Mashanov, O.P. Pchelyakov, L.V. Sokolov
«RHEED intensity oscillation in resonance condition during MBE growth of Si on
Si(111)». Surf. Sci., 327, 93 (1995).
Bert Voigtlander and Martin Kastner «Evolution of the strain relaxation
in a Ge layer on Si (001) – by reconstruction and intermixing», Phys. Rev. B.
V60, N8, R5121 (1999).
O. Kienzle, F. Ernst, O. G. Schmidt et al. «Germanium ‘‘quantum dots’’
embedded in silicon: Quantitative study of self-alignment and coarsening» Appl.
Phys. Lett., V74, N2, 269 (1999).
G. Wohl, C. Shollhorn, O.G. Schmidt et al. «Characterization of
self-assembled Ge islands on Si(100) by atomic force microscopy and
transmission electron microscopy» Thin Solid Films 321 (1998) 86-91.
G. Medeiros-Ribeiro, T. I. Kamins, D. A. A. Ohlberg, and R. Stanley
Williams « Annealing of Ge nanocrystals on Si(001) – at 550 °C: Metastability
of huts and the stability of pyramids and domes» Phys.Rev.B V58, N7, 3533
(1998).
H. Sunamura, N. Usami, Y. Shiraki and S. Fukatsu «Island formation during
of Ge on Si(100): A study using photoluminescence spectroscopy» Appl. Phys.
Lett. 66(22), 3024 (1995).
O. G. Schmidt, C. Lange, and K. Eberl « Photoluminescence study of the
initial stages of island formation for Ge pyramids/domes and hut clusters on
Si( 001)» Appl.Phys.Lett. V75, N13, 1905 (1999)
|